- 企業・官公庁の方へ
- 産官学連携
[ LED共同研究センター ]装置一覧
- ホーム
- 産官学連携
- LED共同研究センター
- 装置一覧

No.1
詳細はこちら-
MOCVD装置
- LED結晶成長

No.2
詳細はこちら-
有機金属気相成長MOCVD装置
- LED結晶成長

No.3
詳細はこちら-
スパッタリング装置
- LEDデバイスプロセス

No.4
詳細はこちら-
マスクアライナー装置
- LEDデバイスプロセス

No.5
詳細はこちら-
高真空蒸着装置
- LEDデバイスプロセス

No.6
詳細はこちら-
熱処置装置
- 基板作製
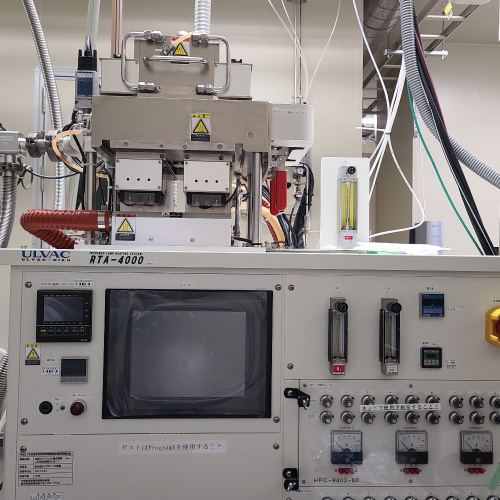
No.7
詳細はこちら-
赤外線ランプアニール装置
- LEDデバイスプロセス

No.8
詳細はこちら-
片面高速ラッピング装置
- LED実装及び評価

No.9
詳細はこちら-
横型平面研削装置
- LED実装及び評価
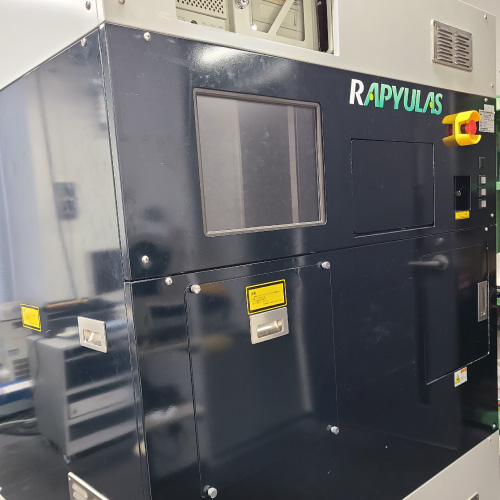
No.10
詳細はこちら-
Sapphire・SiCウェハ切断加工用レーザスクライブ装置
- LED実装及び評価

No.11
詳細はこちら-
PLと透過率ウェハPLマッピング装置
- LED結晶成長

No.12
詳細はこちら-
微分干渉顕微鏡
- 基板作製
- LED結晶成長
- LEDデバイスプロセス
- LED実装及び評価

No.13
詳細はこちら-
薄膜材料評価用X線回折装置
- LED結晶成長

No.14
詳細はこちら-
触針式表面形状測定器
- LEDデバイスプロセス

No.15
詳細はこちら-
3CCDカラーコンフォーカル顕微鏡
- LED結晶成長
- LEDデバイスプロセス

No.16
-
全固体連続発振UVレーザ
- 基板作製
- LED結晶成長

No.17
詳細はこちら-
カソードルミネッセンス観察分析システム
- LED結晶成長
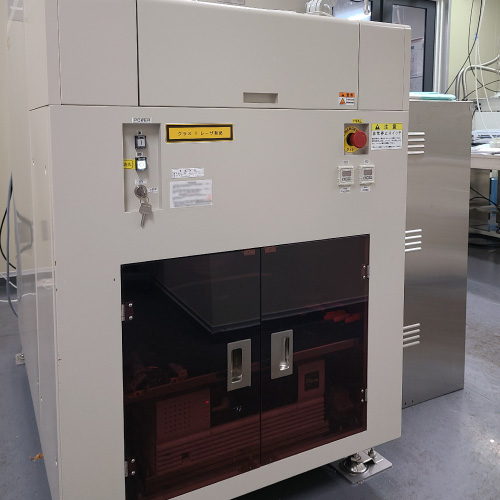
No.18
-
SiCライフタイム測定装置
- 基板作製
- LED結晶成長

No.19
詳細はこちら-
ナノインプリント装置
- LED結晶成長

No.20
-
膜厚モニター
- LED結晶成長
- LEDデバイスプロセス

No.21
-
積分球
- LED実装及び評価

No.22
-
LEDテスター
- LED実装及び評価

No.23
-
スピンコーター
- LEDデバイスプロセス
No.6
熱処置装置
- 基板作製

- ・高周波誘電加熱方式による熱処理装置
- ・結晶、電極の熱処置に使用
- ・PCによる制御及びデータの記録が可能
- ・高精度な圧力制御が可能
- ・コイル可動可能(成長中に温度勾配の変更可能)
- ・高周波電源が本体内蔵のためコンパクト
[ 主な仕様 ]
| 対応ウェハサイズ | 2、3、4inch | 到達圧力 | 1.33×10-3㎩ |
|---|---|---|---|
| 加熱温度 | MAX2,500℃ | 圧力制御範囲 | 1~760 Torr (×133㎩) |
| 雰囲気 | 真空、Ar、N2、He | 測温 | 放射温度計による測温 |
No.12
微分干渉顕微鏡
- 基板作製
- LED結晶成長
- LEDデバイスプロセス
- LED実装及び評価

- ・LED結晶の構造、表面形状および蛍光特性を評価することが可能
- ・観測物の凹凸情報が定性的直観的に判る
- ・CCDカメラにて画像を取り込み、測長等の解析が可能
[ 主な仕様 ]
| 型式 | LV150(落射照明専用機) | LV100D(落射照明/透過照明両用機) | |
|---|---|---|---|
| 観察法 | 明視野・暗視野・微分干渉観察タイプ | ||
| 鏡筒 | 三眼鏡筒(デジカメ装着可能) | ||
| ステージ移動量 | 150×150mm(ウェハホルダー/ESDプレート) | 150×100mm(ガラスプレート) | |
| 総合倍率 | 50、100、200、500、1,000× | ||
No.1
MOCVD装置
- LED結晶成長

LED成長過程リアルタイムX線評価MOCVD装置
- ・LEDエピタキシャル膜の成長に使用
- ・高温成長対応可(~1,400℃)
- ・成長中のXRD測定が可能(結晶構造の解析)
- ・基板サイズ:2inch×3枚
- ・半導体構造成長中に基板成長速度、膜厚、基板反り等を測定し、最適な成長条件の制御に使用
- ・MOCVD成膜装置内の基板上に形成された薄膜をX線反射率測定による膜厚分析、およびX線回折装置による結晶配向性のin-situ測定が可能な分析評価装置
[ 主な仕様 ]
| 対応ウェハサイズ | 2inch×3、3inch×1、4inch×1 |
|---|---|
| ヒーター温度 | 1,400℃ |
| その場観察装置 | Laytec epiTT Two(反射率、曲率、温度の測定) In-situ X-ray(反射率、格子定数、熱膨張) |
| 使用原料 | TMGa×2、TMIn×2、TEGa×1、TMA×1、Et-Cp2Mg、TMSi×1、NH3×2、N2、H2 |
No.2
有機金属気相成長MOCVD装置
- LED結晶成長

- ・LEDエピタキシャル膜の成長に使用
- ・シャワーへッドノズルを使用
- ・Argasシステムによるサセプタ面内の温度モニタリングが可能
- ・2inch×3枚同時成長が可能
- ・装置サイズが非常にコンパクト
[ 主な仕様 ]
| 対応ウェハサイズ | 2inch×3、3inch×1、4inch×1 |
|---|---|
| ヒーター温度 | 1,400℃ |
| その場観察装置 | ・Laytec(成長温度及び表面の反射率測定) ・Argas(サセプタの温度マッピング) ・Epison(原料使用量測定) |
| 使用原料 | TMGa×2、TMAl×2、TMIn×2、TEGa×1、Et-CP2Mg×1、TMSi×1、NH3、N2、H2 |
No.11
PLと透過率ウェハPLマッピング装置
- LED結晶成長

- ・LEDウェハのフォトルミネセンス(PL)特性や、エピ膜の膜厚を透過光により高速に測定し、マッピング可能
- ・高感度分光器
[ 主な仕様 ]
| 対応ウェハサイズ | 2、3、4inch | |
|---|---|---|
| マッピング間隔 | 0.04mm(0.1mm精度) | |
| 透過光による測定 | 精度 1%以内 | |
| 再現性 10㎚以内 | ||
| PL測定 | 測定項目 | ピーク波長/相対積分強度/相対ピーク強度/半値幅(FWHM)/主波長(CIE波長) |
| 波長解像度 | ~0.3㎚(ただしUVNIR-HISENSでは~0.7㎚、NIRでは~2.0㎚) | |
| 光強度精度 | 3% (相対ピーク強度/相対積分強度・YWafer強度校正機能使用時) | |
| 最小半値幅 | ~1.5㎚ | |
No.12
微分干渉顕微鏡
- 基板作製
- LED結晶成長
- LEDデバイスプロセス
- LED実装及び評価

- ・LED結晶の構造、表面形状および蛍光特性を評価することが可能
- ・観測物の凹凸情報が定性的直観的に判る
- ・CCDカメラにて画像を取り込み、測長等の解析が可能
[ 主な仕様 ]
| 型式 | LV150(落射照明専用機) | LV100D(落射照明/透過照明両用機) |
|---|---|---|
| 観察法 | 明視野・暗視野・微分干渉観察タイプ | |
| 鏡筒 | 三眼鏡筒(デジカメ装着可能) | |
| ステージ移動量 | 150×150mm(ウェハホルダー/ESDプレート) | 150×100mm(ガラスプレート) |
| 総合倍率 | 50、100、200、500、1,000× | |
No.13
薄膜材料評価用X線回折装置
- LED結晶成長

- ・X線回折法により大面積サンプルにおいてLEDの原子レベルでの界面急俊性を短時間に評価すること可能
- ・多機能高精度水平ゴニオメーター内蔵
- ・X線回折法により薄膜の結晶性評価が可能
[ 主な仕様 ]
| 対応ウェハサイズ | 2inch、3inch、(4inch) |
|---|---|
| 測定モード | ロッキングカーブ測定(In-planeでの測定も可能)、反射率測定、逆格子空間マッピング測定 |
| 測定データの解析方法 | Global Fit 拡張ロッキングカーブソフトウェア(パラレルテンパリング法) |
| モノクロメータ結晶 | Ge(400)2結晶、Ge(400)4結晶 |
| 波長単色性 | Kα1 |
No.15
3CCDカラーコンフォーカル顕微鏡
- LED結晶成長
- LEDデバイスプロセス

- ・GaN系LED構造結晶の構造観察および結晶形状測定を行うことが可能
- ・ピエゾ素子を用いたことにより、Z方向(高さ)の分解能が1㎚とAFM並の平坦性精度を保障
- ・焦点移動メモリー方式
[ 主な仕様 ]
| 主な仕様 | コンフォーカルモード | 干渉計モード |
|---|---|---|
| Z分解能 | 100㎚ | 1㎚ |
| 解像度 | 高 | 低 |
| 対物レンズ倍率 | MAX100倍 | MAX50倍 |
No.17
カソードルミネッセンス観察分析システム
- LED結晶成長

- ・高電流のフィールドエミッション電子銃を備え、高解像度にて、結晶欠陥の観察が可能
[ 主な仕様 ]
| 主な仕様 | SEM仕様 | |
|---|---|---|
| 対応ウエハサイズ | ~4inch | |
| 加速電圧 | 0.5~30㎸ | |
| 電子銃 | ZrO/W ショットキーエミッション型電子銃 | |
| 装置 特徴 |
5軸モータステージ | X-Y移動の制御はトラックボールにて可能。Z軸移動時にフォーカスが自動追従 |
| ExB搭載 | 二次電子検出器の検出効率を上げる際に生じやすい一次電子の軸ズレを防止し、 高い検出効率を確保 |
|
| OXFORD | SEMの高い分解能を保持したままでのCL検出が可能 | |
| INSTRUMENTS社製 CL mapping装置搭載 |
非常に明瞭な像による各種評価を実現 | |
No.19
ナノインプリント装置
- LED結晶成長
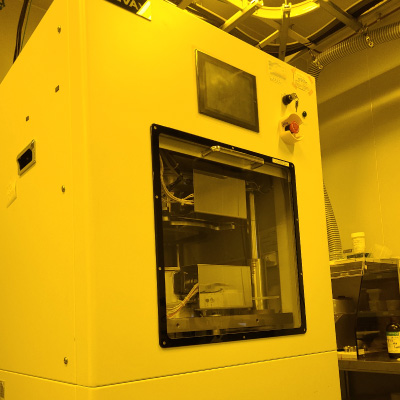
- ・高スループットにて2種類の方法でナノパターン形成が可能
- ・ドライエッチングとの組み合わせで、半導体ナノ構造の作製ができる
[ 主な仕様 ]
| 対応ウェハサイズ | ~4inch |
|---|---|
| 測定モード | 熱可塑性樹脂・UV硬化性樹脂 |
| 装置特徴 | 熱式/UV式の切り替えが容易 ・樹脂の特性によって装置を熱印加方式・UV照射方式に切り替えることが可能 ・熱式/加熱最高温度:250℃,最大荷重力:50kN ・UV式/波長:365㎚,照度:30㎽/㎠ |
No.3
スパッタリング装置
- LEDデバイスプロセス

- ・LEDや半導体レーザーに必要な誘導体や金属の製膜に使用
- ・広範囲に膜厚分布が良いスパッタ源を標準搭載(170±5%(SiO2))
- ・低温でも高温でも成膜が可能
- ・クリーンなサイドスパッタとロードロック室を装備
[ 主な仕様 ]
| 主な仕様 | i-Miller |
|---|---|
| スパッタ方式 | サイドスパッタ |
| スパッタ源 | φ3inch×3 |
| ホルダーサイズ | φ200 |
| 到達圧力 | 5×10-4㎩(2×10-5㎩) |
| 排気時間(10分で) | 7×10-3㎩ |
| 排気操作方式 | 自動 (全自動) |
| スパッタ操作方法 | 手動(全自動) |
| 電源 | RF500W(DC1㎾) |
| 加熱温度 | 300℃ |
| エッチング | RF500W |
| 本体寸法 | W1,250×D811×H1,582 |
No.4
マスクアライナー装置
- LEDデバイスプロセス

- ・LEDや半導体レーザーの電極パターニングの形成に使用
- ・㎛オーダーの微細パターニングが可能
- ・フィードバック回路により高い露光量再現性を実現
[ 主な仕様 ]
| 対応ウェハサイズ | 2、3、4inch(不定形にも対応可) | |
|---|---|---|
| 照度仕様 | 照度径 | 130mm |
| 照度 | 13㎽/㎠ | |
| 照度分布 | ±5㎛ | |
| 装置特徴 | マルチミラー光源による光の回折効果を低減 | |
No.5
高真空蒸着装置
- LEDデバイスプロセス

- ・高真空下で、金属を昇華させ、ターゲットに製膜する装置。LEDの電極形成に用いる。
- ・12枚用ホルダで多数枚処理が可能
- ・金属は7ターゲット同時投入可能で多層膜成膜も容易
[ 主な仕様 ]
| ウェハホルダー | 自転型プラネタリ方式(12スロット) | |
|---|---|---|
| 対応ウェハサイズ | 2、3、4inch(不定形にも対応可) | |
| 成膜精度 | 設定膜厚±5% | |
| 装置 特徴 |
ターゲット搭載数 | EB源:4スロット、抵抗加熱源:3スロット |
| 真空排気能力 | クライオポンプ搭載:1E-4[㎩]まで約30[min]で到達 | |
No.7
赤外線ランプアニール装置
- LEDデバイスプロセス

- ・LED素子及び成膜素子を急加速熱によってアニール処理を行うこと可能
- ・ランプ出力を独立制御することにより面内における温度均一性が高い
- ・上部下部ランプ加熱方式
[ 主な仕様 ]
| 対応ウェハサイズ | 2、3、4inch(不定形にも対応可) |
|---|---|
| 昇温仕様 | 温度範囲:RT~1,100℃ 昇温速度:30℃/sec 均熱精度:ΔT=10℃ |
| 装置特徴 | 搭載ガスライン N2:2L/min(MAX)、O2:2L/min(MAX) |
No.12
微分干渉顕微鏡
- 基板作製
- LED結晶成長
- LEDデバイスプロセス
- LED実装及び評価

- ・LED結晶の構造、表面形状および蛍光特性を評価することが可能
- ・観測物の凹凸情報が定性的直観的に判る
- ・CCDカメラにて画像を取り込み、測長等の解析が可能
[ 主な仕様 ]
| 型式 | LV150(落射照明専用機) | LV100D(落射照明/透過照明両用機) |
|---|---|---|
| 観察法 | 明視野・暗視野・微分干渉観察タイプ | |
| 鏡筒 | 三眼鏡筒(デジカメ装着可能) | |
| ステージ移動量 | 150×150mm(ウェハホルダー/ESDプレート) | 150×100mm(ガラスプレート) |
| 総合倍率 | 50、100、200、500、1,000× | |
No.14
触針式表面形状測定器
- LEDデバイスプロセス

- ・直径150mm以下の基板上の膜厚段差、表面粗さ、うねりなどの表面形状を高精度に測定
- ・高剛性のキャストフレームと実績のあるセンサヘッドで、安定した測定再現性を実現
- ・測定距離は55mmまで設定でき、段差以外に基板の表面粗さやうねりの解析も可能
- ・触針の交換は、専用治具を利用するため簡単
[ 主な仕様 ]
| 主な仕様 | 手動ステージタイプ |
|---|---|
| 垂直分解能/測定レンジ | 0.1㎚/6.5㎛、1㎚/65.5㎛、8㎚/524㎛(オプション:16㎚/1mm) |
| 膜厚測定再現性 | 1σ= 0.6㎚以下 |
| 測定距離 | 50㎛~55mm |
| サンプリングデータ数 | 最大120,000点 |
| 触針圧 | 1~15mg(オプション:0.03~15mg) |
| サンプルステージ直径 | 150mm |
| 最大サンプル厚 | 85mm |
| ステージ移動範囲 | X:+75mm、-25mm 手動 Y:±50mm 手動 θ:360°手動 |
| サンプル観察 | カラーズームカメラ : 視野0.67~4.29mm(±10%) |
| 17型モニタ上の倍率 : 80倍~514倍(±10%) | |
| 操作環境(OS) | Microsoft® WindowsXP (英語版) |
No.15
3CCDカラーコンフォーカル顕微鏡
- LED結晶成長
- LEDデバイスプロセス

- ・GaN系LED構造結晶の構造観察および結晶形状測定を行うことが可能
- ・ピエゾ素子を用いたことにより、Z方向(高さ)の分解能が1㎚とAFM並の平坦性精度を保障
- ・焦点移動メモリー方式
[ 主な仕様 ]
| 主な仕様 | コンフォーカルモード | 干渉計モード |
|---|---|---|
| Z分解能 | 100㎚ | 1㎚ |
| 解像度 | 高 | 低 |
| 対物レンズ倍率 | MAX100倍 | MAX50倍 |
No.8
片面高速ラッピング装置
- LED実装及び評価

- ・ウェハの鏡面仕上げを行う装置
- ・数種のダイヤモンド砥粒を使い分けることにより、非常に高い表面平坦性が確保できる
- ・荷重調整により、安定した研磨レートを実現
[ 主な仕様 ]
| 対応ウェハ材質 | Sapphire、SiC、Si | |
|---|---|---|
| 対応ウェハサイズ | 2、3、4inch(不定形にも対応可) | |
| 保障精度 | 設定膜厚±3㎛以内 | |
| 装置 特徴 |
300mmφ・錫定盤 | 大型定盤仕様により大型ウェハに対して、非常に面内分布均一性が向上 |
| 荷重制御 | ワークのサイズに合わせた、加工時の印可荷重を設定可能 | |
| ダイヤモンドスラリー | 目標加工精度に応じてスラリー粒径を選択可能 | |
No.9
横型平面研削装置
- LED実装及び評価

- ・LED基板を研削し、膜厚調整を行う。実装工程他各種検討に必要不可欠な装置である
- ・ダイヤモンド砥石を用い、Sapphire、SiC等を容易に研削可能
- ・間欠送り機構により難削材に対してもダメージを抑えた加工を実現
- ・ゼロタッチモード搭載で、非常に高い研削量制御性を確保
[ 主な仕様 ]
| 対応ウェハ材質 | Sapphire、SiC、Si | |
|---|---|---|
| 対応ウェハサイズ | 2、3、4inch(不定形にも対応可) | |
| 保障精度 | 設定膜厚±10㎛以内 | |
| 装置 特徴 |
ZERO touchシステム | 砥石とワーク接触時の付加を検知し、加工開始点を補正⇒設定加工量に対し、 高精度な加工を実現 |
| 間欠送り | ワーク送りを間欠化し、ワークへのダメージを軽減能 | |
No.10
Sapphire・SiCウェハ切断加工用レーザスクライブ装置
- LED実装及び評価

- ・LED素子のチップ化を行う装置で、従来のダイヤモンド刃型のタイプに比べ、ダメージフリー・低輝度低下率での加工が可能
- ・高出力YAGレーザーを用い、高速度・高精度加工が可能
- ・8inchホルダーによって10㎟角~6inchウェハまで様々なサイズに対応
- ・形状認識システムによる操作性・スループットの向上を実現
[ 主な仕様 ]
| 対応ウェハ材質 | Sapphire、SiC、Si | |
|---|---|---|
| 対応ウェハサイズ | 2、3、4inch(不定形にも対応可) | |
| 加工精度 | 加工深さ:約50㎛ | |
| 加工線幅:約30㎛ | ||
| 装置 特徴 |
オートアライメント | 形状認識システムによる高精度・高スループット加工が可能 |
| バッチ処理 | ワークカセット3個投入可能(ウェハ25枚/カセット) | |
| 加工速度 | 高出力YAGレーザーにより100mm/secの加工速度 | |
No.12
微分干渉顕微鏡
- 基板作製
- LED結晶成長
- LEDデバイスプロセス
- LED実装及び評価

- ・LED結晶の構造、表面形状および蛍光特性を評価することが可能
- ・観測物の凹凸情報が定性的直観的に判る
- ・CCDカメラにて画像を取り込み、測長等の解析が可能
[ 主な仕様 ]
| 型式 | LV150(落射照明専用機) | LV100D(落射照明/透過照明両用機) |
|---|---|---|
| 観察法 | 明視野・暗視野・微分干渉観察タイプ | |
| 鏡筒 | 三眼鏡筒(デジカメ装着可能) | |
| ステージ移動量 | 150×150mm(ウェハホルダー/ESDプレート) | 150×100mm(ガラスプレート) |
| 総合倍率 | 50、100、200、500、1,000× | |





